�����M�b���g���
����һ���Ї��֙C�S�̡������dͨӍ���Z���и߹��tϵ�y�Ľ�B���֙C��M�b�Ĺ�ˇ���Ժ�14�����ͺ��ӆ��}�������c������CSP���c�ն���PCB�ӵij����c��Q�@Щ���}˼·�ͷ������Z���н�B�����ӆ��}��Ҫ������PCB�����ο��B������EMI�����ϣ����OӋ�c�����^������Ҫ�eע�⡣
��С�p�����֙Cڅ�ݣ��O��S�̷e�O����
�v�^��ǰ�Ј�����С�p���ѽ��ɞ��֙C�����lչڅ�ݣ��@Ҳ�o�֙C�����O��S�̎����˺ܶ��C���c������CMMF2009�У����µġ��I��һ�������S�֙C���匍�b���g���������bƽ�_DSP/NPM�����Wķ�����o�茣�I���ܵ�AOI���Լ������Ԅӻ������ġ��x���Ժ��Ӽ��g�đ��á��������@�����ܶȣ��������S�֙C������OӋ�����죬�Ƴ����Լ��ļ��g���O���Լ���Q������
��������C늣����ڣ�����˾FA���g���ď���ɲ��Lָ����IC���l���ѽ��ɞ��֙C�����c���b���g���R��������𣬞��˽�Q�@һ�n�}������һֱ�������о���N�֙C���b���g����ܛӲ�Y�ϰ塢POP�M�b��СԪ�����ܶȌ��b�ȣ���������߀�Ƴ����I��һ�������S�֙C���匍�b���g��
�Ї������ă��������O���̴�������Ԅӻ��ѽ����ǵ�һ�΅���CMMF�ˣ��ڱ���Փ���У������Ԅӻ����������_�����Ҏ������x���Ժ��Ӽ��g������ʾ���x���Ժ��Ӽ��g������һ�����µļ��g�����^����H�m���ڲ��bԪ���ĺ��ӣ������漰���ɱ���Ч���Լ����g�����һЩ���}�������Ј���߀�]�д�������ʹ�á����^�c��ͨ���庸��ȣ��x���Ժ��ӵă���ʮ�����@����������ֻ��ҪͿ��PCB�²��Ĵ����Ӳ�λ������������PCB�����һ����Ͽ���������ȱ�ݵĺ��ӡ������S���x���Ժ��Ӽ��g�c�O����Mһ���lչ��δ�팢���֙C������ИI�l�]�����á�
�Wķ���Ԅӻ����Ї�������˾���g���ս��폈�����߹��t���ҷ������Y��ʹ��AOI�r�Ķ�l���}�������EzTS�������o�茣�I���ܾ��ܺ�����ɵĽ�Q��������ͨ�^���H�����еĔ����yӋ��C�����Q�n�}��������������B��������Ҫ���Ă������w�F��EzTS������һ����С��Ŀҕ�_�J���ڶ����z��D���ԄӴ惦�����������FAOI�\�à�r���������ģ��l�����Ժ��ξ��̡�
�ͳɱ��������֙C�a�I���R��ˇ����
�ڶ�ܡ������ܡ�С�ͻ��İlչڅ��֮�⣬�ͳɱ�Ҳ�Ǯ����֙C�����ИI����挦�Ć��}�������������a�^���Ќ����¼��g�����M�������e�e�O�������J��͑����P�ĵ��ǮaƷ�Ĺ��ܡ��|���Լ��r���Dz��ǝM��������Ҫ�������ǮaƷ�Dz���ʲô���g��������ġ��� ������Ӹ����̎�Ph.D Tae-Sang Park��CMMF2009�ϱ�ʾ��PCB�OӋ���֙C���a������ʮ����Ҫ��һ���нM�����OӋ�^������ߏS�̸��������P�I�h��֮һ��
��������ˇ�����_�l���÷�����@�ڡ�EMS��˾�֙C�Ŀ�����a����ģʽ����ˇ�ܿء� ��Ԕ����B��EMS��˾�֙C�Ŀ�Ĺ���ģʽ�����Ľӵ��͑��Ĵ��Ҫ�M�ɈFꠡ��ʂ�ԭ���c�����O�䡢ԇ�Ӽ��M�����a�������Ŀ�������̣��Լ��ڴ�����������cOEM��ͨ��Q���a�г��F�Ĺ�ˇ���}������Ҫ��B�����֙C�aƷ�����Ԫ������ܻ���څ���£�EMS��˾��������������������һЩ��ˇ�_�l������
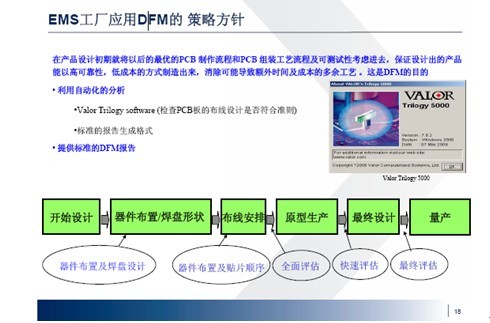
EMS���S����DFM�IJ��Է��
���ˌ��֙C�������������ߵ�ˮƽ���a�I�����M���c���y��ˇ��Ȼ��ͬ�ļ��g���¡���ۿƼ���W���Mϵ�y���b�������������|��ʿ�ԡ�δ���֙C�c��y�O������ĸ��·��b���g�����}��Ԕ����B�����d�ķ��b���g������Ƕ��ʽ�����Ⲩ����ݔ������ʾ���@Щ���¼��g������ڸ��ܶ��ЙC�C���ό��F������������δ���֙C�c��y�O��ĮaƷ�ͻ���ϵ�y���ϴ��_ȫ�µľ��档
 IC���b���g�lչ��ʮ��
IC���b���g�lչ��ʮ��
��ۿƼ���W�Cе�WԺ���h�\��ʿ�ڵڶ���Ĺ������О��Ҏ�����3D IC��SIP��TSV�����¼��g�������Z���������ǡ�intel�ȏS�̵İ��������@Щ���g�đ����cǰ��������㟿Ƽ���˾�����������ʿ�Լ��_������ʿ�քe�I�Ҳ�քe��С�ͻ��M�����R�������֙C������P�I�Ӽ��g�����������OӋ--�������֙C�M�b���g����y�O���Пo�U���c�ɿ������R���}�Ⱦ��w���}�c�֙C���칤�̎��M�������뽻���c̽ӑ��
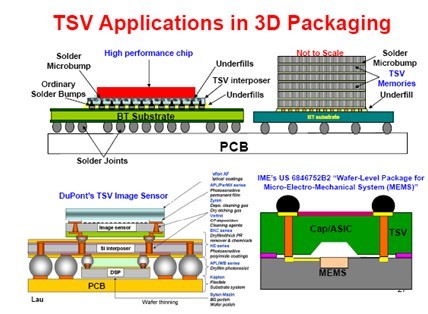
3D���b�е�TSV���g
�Ї��֙C���켼�gՓ���ɸ߽������չ�Mί���̈́���r����ͬ�e�k���Ǹ߽������չ���g���ذ����h֮һ�����״��e�k����Ӵ��˽���ǧ���֙C�����ИI�����ˆT�����g�ˆT���ѽ��ɞ��Ї��֙C�����ИI�ļ��g�L��ˡ�


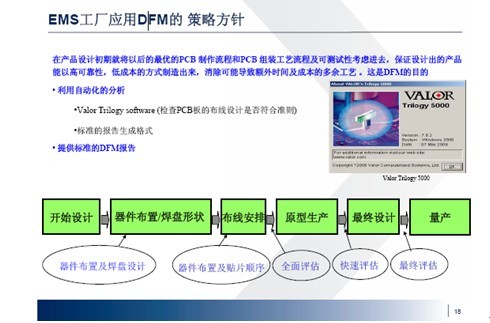

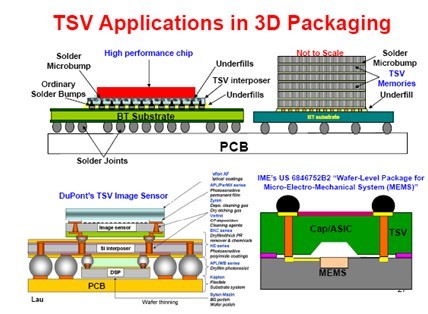
![������I�]��](../img/news/240_150.jpg)
